リフトオフプロセス
ウエットエッチングを用いたプロセスでは配線形成が困難な金属(Pt、Ta等)やウエットエッチングは可能だが、膜構成によっては下層へのダメージが懸念される場合(ITO上のSiO2等)に用います。
対応金属膜
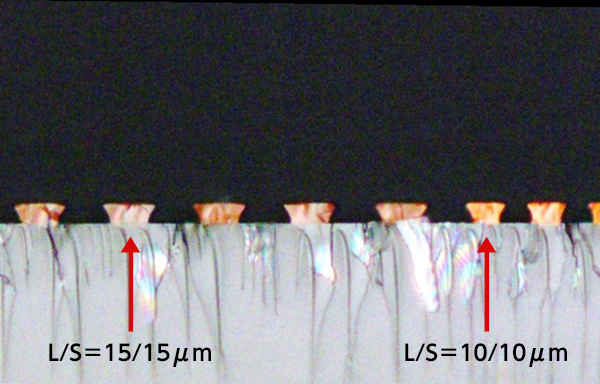
Pt、Ta、SiO2、SiNなど
- 最小L/S=10/10μm
- 配線高さ=~2μm
- 対応基板サイズ
~200×200mm
~Φ200mm
工程フロー


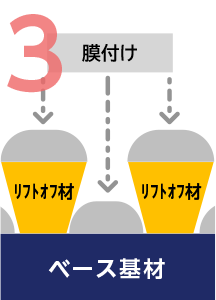







ウエットエッチングを用いたプロセスでは配線形成が困難な金属(Pt、Ta等)やウエットエッチングは可能だが、膜構成によっては下層へのダメージが懸念される場合(ITO上のSiO2等)に用います。
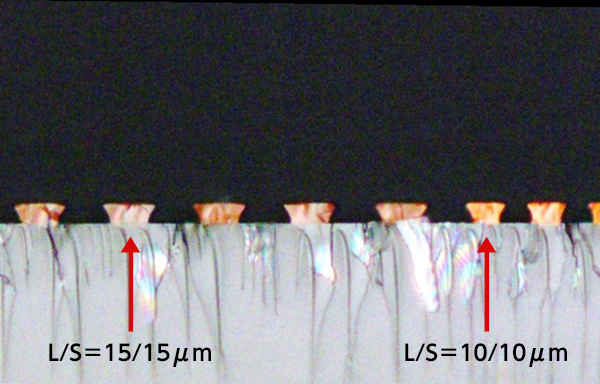
Pt、Ta、SiO2、SiNなど


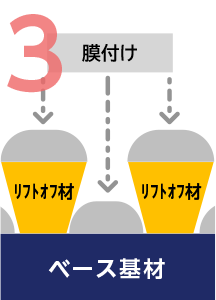







当社に関するお問い合わせや試作や量産などのお問い合わせは
お電話またはお問い合わせフォームよりお寄せください。
業務効率化のため、営業・販促に関するご連絡は原則お断りしております。
ご理解とご協力を賜りますよう、よろしくお願い申し上げます。